近日LCD驱动IC晶圆凸块封装供应商江苏晶度半导体科技有限公司(以下简称“晶度半导体”)宣布完成数千万人民币战略投资,由勤合创投领投。
据了解,江苏晶度半导体科技有限公司作为江苏壹度科技全资子公司,位于壹度科技园区6、8、10栋,厂房总建筑面积2.6万平方,设有百级无尘车间3500平方,千级无尘车间7500平方,半导体项目预计总投资12亿元,主要为行业提供LCD驱动IC的封装测试统包服务。
LCD驱动IC统包封装与测试服务,依据客户需求,提供Wafer从凸块,晶圆测试,减薄划片,封装,最终测试等制程,并将完成的产品COF/COG送至客户指定地点。目前凸块加工包括金凸块(AuBump)、铜镍金凸块(CuNiAuBump)等。
而母公司壹度科技则联合南京大学、南京邮电大学及句容市政府共同投资,是一家集芯片金凸块、封装测试、安防/汽车光学镜头、通讯物联终端技术/指挥系统集成、液晶屏与触控屏全贴合、生产辅料模切等研发、生产、销售等一站式专业制造服务的校、政、企股份制公司。
AuBump金凸块制造是指一种利用金凸块接合替代引线键合实现芯片与基板之间电气互联的制造技术。根据工艺制程不同,金凸块制造技术可分为金凸块制造(GB)、晶圆测试(CP)、玻璃覆晶封装(COG)、薄膜覆晶封装(COF)等环节。金凸块制造具体工艺流程为完成基本电路的晶圆,通过清洗、溅镀、上光刻胶、电镀、蚀刻等环节由封测代工厂在芯片焊垫上制作金属凸块的过程。
与传统打线技术相比,金凸块制造技术以黄金、铜材等为凸块材料,具有导电性能良好、散热效果好、工作可靠性高、机械加工性能强、密度大、成本低等优点。目前金凸块制造技术主要应用于显示驱动芯片、CMOS图像传感器、射频识别芯片、指纹传感器等制造场景,终端应用领域包括手机、电脑、电视、平板电脑等领域。
金凸块制造技术是新型高端封装技术之一,当前其最大应用场景为显示驱动芯片。近年来,在手机、电脑等终端市场快速发展带动下,全球显示驱动芯片市场出货量不断提升,而金凸块制造技术作为显示驱动芯片封测核心量产工艺,其市场需求不断增加、规模不断扩大。

驱动IC与面板结合有两种方式:COG(Chiponglass),将Chip直接与液晶面板玻璃基板接合。COF(Chiponfilm),将Chipbonding在软性电路板再与液晶面板玻璃基板接合。统包服务整合了各制程封装技术提供了完整COG及COF封装制程。
晶圆凸块简称凸块。目前晶度可生产包括金凸块(GoldBump)、铜镍金凸块(CuNiAuBump)、厚铜(ThickCu)、铜柱凸块(CopperPillarBump)在内的多种产品。其中铜镍金凸块(CuNiAuBump)产品,是利用薄膜、黄光、电镀及蚀刻之制程在晶片之焊垫上制作凸块。此技术可大幅缩小IC的体积,并具有密度大、低感应、低成本、散热能力佳等优点,目前铜镍金凸块技术多应用于LCD驱动IC,可直接嵌入显示屏幕上以节省空间。
其中COF是一种IC封装技术,是运用软性基板电路(flexibleprintedcircuitfilm)作为封装芯片的载体,透过热压合将芯片上的金凸块(GoldBump)与软性基板电路上的内引脚(InnerLead)进行接合(Bonding)的技术。在LCD全面屏显示产品中,COF是主要的IC封装技术。
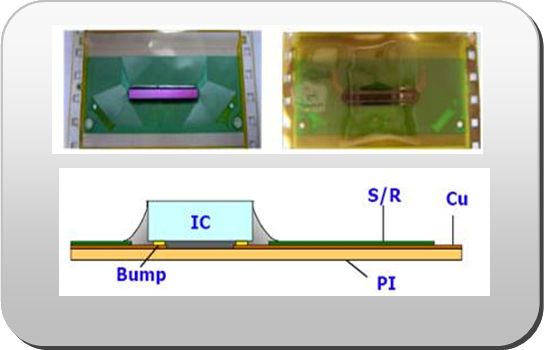
晶度半导体核心团队长期致力于晶圆生产工艺研究,并与南京大学光电工程研究院在产学研方面紧密合作。晶度半导体具有先进的晶圆凸块及集成电路封装、测试生产线,从事专业封装、测试服务、建设金凸块、COF、COG等先进封装生产工艺,满足对LCD驱动器集成电路作植凸块、封装、测试加工服务。
目前全球具备金凸块制造技术的企业主要有IBM、Nepes集团、日月光、LBSemiconInc、DuPont、AmkorTechnology等;本土企业主要有颀中科技、汇成股份、同兴达、通富微电子、南茂科技、晶度半导体等。当前在全球半导体产业朝中国转移趋势不断攀升背景下,本土电子封装企业技术不断升级,具备金凸块制造技术的企业数量正不断增加,国内金凸块制造行业发展潜力巨大。
而显示驱动芯片受全面屏显示技术的普及,以及柔性AMOLED显示屏的出货量不断增长,COF封装技术得到了行业的大力推广,显示驱动芯片金凸块制造、封测业务的行业需求也同样越来越高。
数据显示2022年全球显示驱动芯片(DDIC)的总需求近80亿颗,2023年预计将保持持平。中国台湾和韩国的IC厂商在大尺寸DDIC市场仍占据最大份额,而中国大陆的份额也在持续增长。
壹度科技客户包括了台湾联咏、奇景、汇鼎、仁宝、京东方、中电熊猫、LG、欧菲光、纬创、信利等。晶度半导体驱动IC产品透过壹度制程整合方案及一贯质量管理计划,有效缩短产品制程Cycletime,并提供完整技术支持服务,为客户提供有效解决方案。